

Hommer Zhao
Oprichter PCB Assemblage | 15+ jaar ervaring in PCB productie
Onze fabriek verwerkt dagelijks BGA packages tot 0.3mm pitch. In deze gids deel ik de kennis die wij in 15 jaar hebben opgebouwd — inclusief de fouten die ik anderen zie maken en de oplossingen die écht werken.
"Als een ontwerpteam in de eerste review al IPC-2221, een procesmarge van 20% en minimaal 3 kritische DFM-punten vastlegt, zien wij de first-pass yield doorgaans direct boven 98% uitkomen."
Hommer Zhao, Founder & CEO, WIRINGO
Voor een snelle vervolgstap zijn onze gidsen over DFM-checks, PCB testen en IPC-kwaliteitsklassen de meest gebruikte referenties in onze offertefase.
"Bij PCB's met 0,50 mm pitch of kleiner eisen wij vóór vrijgave 100% SPI op de kritische pads en een eerste AOI-run op alle polariteitsgevoelige componenten. Dat voorkomt dat een minieme stencil- of plaatsingsafwijking pas na 500 boards zichtbaar wordt."
Hommer Zhao, Founder & CEO, WIRINGO
Wat is BGA Assemblage?
BGA (Ball Grid Array) is een type IC-package waarbij de elektrische verbinding met de printplaat niet via pinnen aan de zijkant verloopt, maar via een raster van soldeerballen aan de onderzijde van het component. Bij reflow soldering smelten deze ballen en vormen ze een permanente verbinding met de PCB-pads.
BGA wordt ingezet bij complexe IC's — processors, FPGA's, SoC's en high-speed geheugen — die honderden tot duizenden aansluitingen nodig hebben. Waar een QFP-package beperkt is tot circa 300 pins, biedt BGA ruimte voor meer dan 2000 verbindingen in een compact formaat.
Pins per BGA package
Minimale pitch (µBGA)
Yield bij juist proces
Plaatsingsnauwkeurigheid
Waarom BGA in Plaats van QFP of QFN?
| Eigenschap | BGA | QFP | QFN |
|---|---|---|---|
| Max. aantal pins | 2000+ | ~300 | ~100 |
| Minimale pitch | 0.3mm | 0.4mm | 0.4mm |
| Thermische geleiding | Uitstekend | Matig | Goed |
| Signaalintegriteit | Excellent | Matig (lange leads) | Goed |
| Visuele inspectie | Niet mogelijk | Goed | Beperkt |
| Inspectie methode | X-ray vereist | AOI voldoende | AOI + X-ray |
| Rework moeilijkheid | Hoog | Laag | Gemiddeld |
| Assemblage kosten | Hoger | Laag | Gemiddeld |
BGA types die wij verwerken
PBGA (Plastic), CBGA (Ceramic), TBGA (Tape), µBGA (Micro), FCBGA (Flip Chip), PoP (Package-on-Package) en CSP (Chip Scale Package). Elk type heeft specifieke reflow-profielen en inspectie-eisen. Bekijk onze BGA & µBGA montage service voor de volledige specificaties.
Het BGA Solderproces Stap voor Stap
BGA soldering is een kritisch proces waarbij elke stap de uiteindelijke kwaliteit beïnvloedt. Hieronder het volledige proces zoals wij het dagelijks uitvoeren — van stencildruk tot eindcontrole.
Stencildruk (Solder Paste Printing)
~50% van alle BGA defecten ontstaat hier
Solderpasta wordt via een laser-gesneden stencil op de PCB-pads aangebracht. Voor BGA is dit de meest kritische stap: te weinig pasta geeft open verbindingen, te veel veroorzaakt bridges.
Kritische parameters: Stencildikte 100-150µm (125µm standaard voor 0.5mm pitch) • Aperture ratio >0.66 • Rakeldruk 3-7 kg • 3D SPI-inspectie verplicht na elke print
Componentplaatsing (Pick & Place)
Nauwkeurigheid tot ±25µm vereist
Het BGA-component wordt door een high-precision pick-and-place machine op de PCB geplaatst. Vision-systemen controleren de uitlijning van de soldeerballen ten opzichte van de pads. Bij fine-pitch BGA (<0.5mm) is een afwijking van meer dan 0.1mm al voldoende voor defecten.
Onze apparatuur: Plaatsingsnauwkeurigheid ±25µm • Vision alignment op fiducials + BGA-ballen • Plaatsingssnelheid tot 30.000 CPH • Automatische coplanariteit-check
Reflow Soldering
Thermisch profiel bepaalt de soldeerverbinding
De PCB doorloopt een reflow-oven met een nauwkeurig gecontroleerd temperatuurprofiel. De solderpasta smelt, de BGA-ballen smelten en vormen samen een metalurgische verbinding met de PCB-pads. Het profiel moet zorgvuldig worden afgestemd om defecten als head-in-pillow en voids te voorkomen.
Lead-free profiel (SAC305): Preheat 60-100°C (45s) → Soak 150-200°C (60-120s) → Peak 235-245°C → TAL <3 min boven 217°C → Cooling <4°C/sec
Inspectie & Test
X-ray is onmisbaar bij BGA
Na reflow volgt een uitgebreide inspectieketen: AOI voor zichtbare componenten, X-ray voor BGA-soldeerverbindingen en elektrische test (ICT of flying probe) voor functionele verificatie. Bij IPC Klasse 3 is 100% X-ray inspectie standaard.
Inspectieketen: 3D SPI → AOI na reflow → 2D/3D X-ray → ICT / flying probe → functionele test (optioneel)
De #1 fout die ik bij klanten zie
De meeste BGA-problemen ontstaan niet bij het solderen, maar bij het stencilontwerp. Ik zie regelmatig dat engineers de stencilapertures kopiëren van het component datasheet zonder aanpassing aan de pastadepositie. Bij 0.5mm pitch of kleiner moet u werken met gereduceerde apertures (80-90% van padgrootte) en een dunner stencil. Investeer hier — het bespaart u rework achteraf.
"Mijn vuistregel is eenvoudig: controleer elk ontwerp tegen IPC-A-610, IPC-2221 of IPC/WHMA-A-620 en houd minimaal 10% mechanische en thermische marge aan voordat u vrijgave geeft."
Hommer Zhao, Founder & CEO, WIRINGO
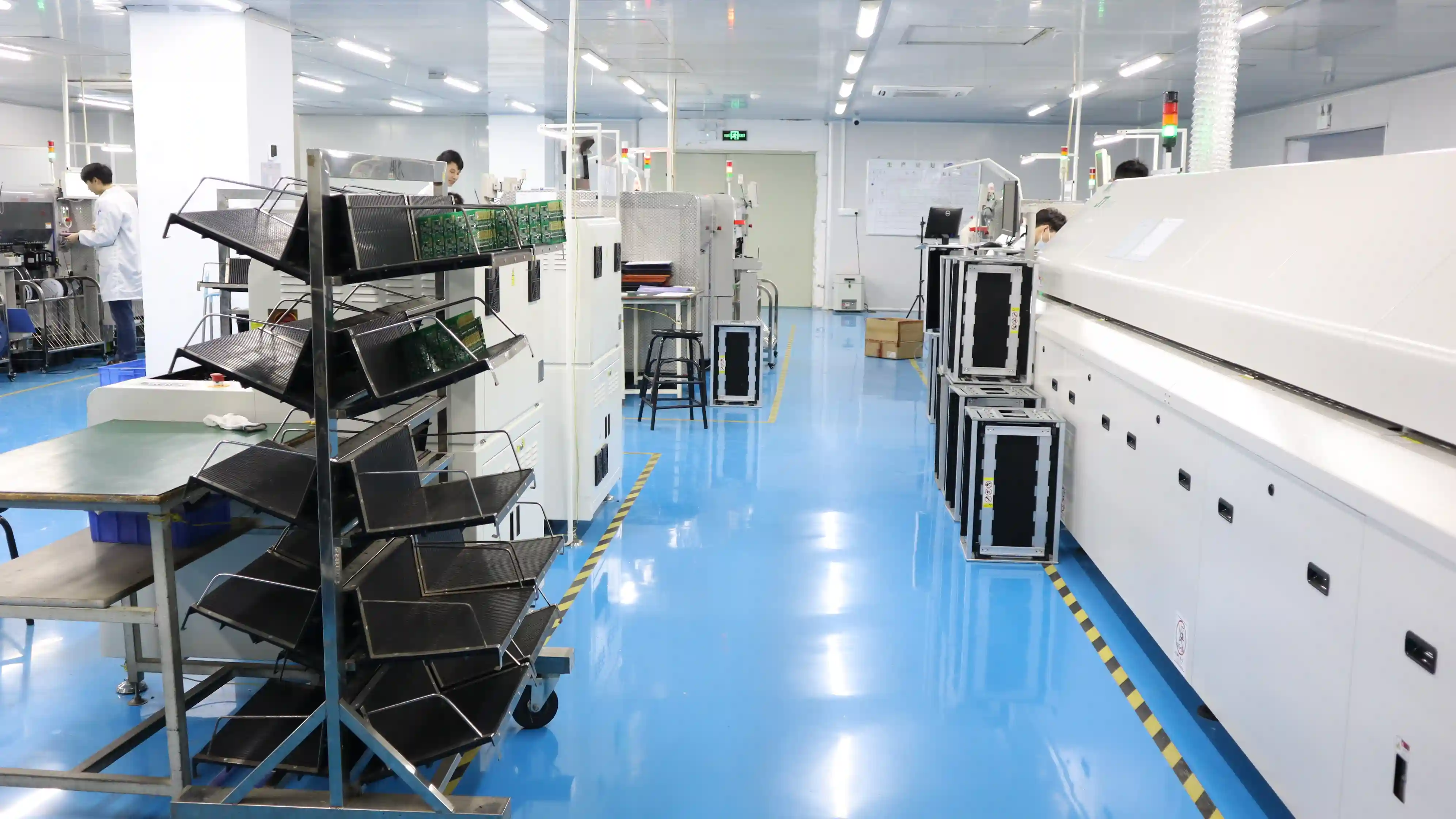
Veelvoorkomende BGA Defecten: Herkennen & Voorkomen
BGA-defecten zijn bijzonder problematisch omdat ze verborgen zijn onder het component. Volgens industriegegevens is meer dan 30% van alle vroege elektronicastoringen te herleiden tot soldeerfouten. Hier zijn de zes meest voorkomende BGA-defecten en hoe u ze voorkomt.
1. Solder Bridges (Kortsluiting)
Naburige soldeerballen vloeien samen en creëren een onbedoelde elektrische verbinding. Komt vooral voor bij fine-pitch BGA (<0.5mm) en veroorzaakt directe functiestoringen.
Oorzaken: Te veel solderpasta, verkeerde stencildikte, onvoldoende padseparatie
Preventie: 3D SPI na stencildruk, gereduceerde apertures, NSMD pad design
2. Head-in-Pillow (HiP)
De soldeerpasta en de BGA-bal smelten allebei, maar vormen geen metalurgische verbinding — alleen mechanisch contact. Dit defect is bijzonder verraderlijk: boards passeren vaak de initiële test maar falen later onder thermische stress of vibratie.
Oorzaken: Component warpage, oxidatie van soldeerballen, verkeerd reflow-profiel
Preventie: Nitrogen reflow, bake-out vochtige componenten, profiel-optimalisatie
3. Solder Voids (Luchtinsluitsels)
Luchtbellen in de soldeerverbinding die de mechanische sterkte en thermische geleiding verminderen. Voids tot 10% van het soldeeroppervlak zijn doorgaans acceptabel; boven 25% wordt de betrouwbaarheid kritiek aangetast.
Oorzaken: Uitgassing flux, vocht in PCB/component, via-in-pad zonder vulling
Preventie: Vacuum reflow, bake-out, via-in-pad pluggen met epoxy
4. Open Verbindingen
Geen elektrische verbinding tussen BGA-bal en PCB-pad. Kan worden veroorzaakt door onvoldoende solderpasta, misalignment of non-wetting door oxidatie.
Oorzaken: Te weinig pasta, pad-oxidatie, warpage, verkeerde coplanariteit
Preventie: ENIG of OSP finish, SPI-controle, coplanariteitscheck
5. Misalignment (Verschuiving)
Het BGA-component verschuift tijdens het reflow-proces. Bij standaard pitch (>0.8mm) corrigeert de oppervlaktespanning van het soldeer kleine verschuivingen (self-alignment). Bij fine-pitch is dit effect zwakker en is precisie-plaatsing cruciaal.
Oorzaken: Conveyor vibratie, onvoldoende flux tack, asymmetrisch pad design
Preventie: Vision alignment, symmetrische pads, stabiele reflow-conveyorsnelheid
6. Microscheurvorming (Fatigue Cracks)
Haarvijne scheurtjes in de soldeerverbinding die ontstaan door thermische cycling of mechanische stress. Bij 0.4mm pitch BGA met 0.2mm hoogte kan vibratie een weerstandstoename van 300% veroorzaken. Dit defect manifesteert zich pas na weken of maanden in het veld.
Oorzaken: CTE mismatch (PCB vs component), thermische cycling, mechanische schok
Preventie: Underfill applicatie, juiste PCB-materiaal, beperking van board flex
Let op: intermittente storingen
Het gevaarlijkste aspect van BGA-defecten is dat ze intermittent kunnen zijn. Een board passeert de fabriekstest maar faalt in het veld door thermische expansie of vibratie. Investeer in X-ray inspectie en — voor kritische toepassingen — in thermische cycling tests vóór uitlevering.
BGA Inspectie: X-Ray, AOI & Elektrische Test
Omdat BGA-soldeerverbindingen verborgen zijn onder het component, is standaard visuele inspectie onmogelijk. Een robuust inspectieprogramma combineert meerdere methoden voor volledige dekking.
X-Ray Inspectie
ESSENTIEELDe enige methode om soldeerverbindingen onder het BGA-component te beoordelen. Röntgenstraling dringt door het component en maakt voids, bridges, opens en balvorm zichtbaar.
- Detecteert voids, bridges, opens, cold joints
- 2D en 3D (CT) varianten beschikbaar
- Meet void percentage (acceptatiecriterium: <25%)
3D SPI (Solder Paste Inspection)
PREVENTIEFInspecteert de solderpastadepositie vóór componentplaatsing. Meet volume, hoogte en positie van elke pastadepot. Dit is de meest effectieve preventieve maatregel.
- Detecteert 50%+ van potentiële BGA-defecten vóóraf
- 3D volumemeting per individueel pad
- Realtime SPC feedback naar stencilprinter
AOI (Automated Optical Inspection)
AANVULLENDKan alleen de buitenste rij BGA-ballen beoordelen. Wel essentieel voor alle andere SMD-componenten op de board en voor het detecteren van BGA-componentpositionering.
- Controleert BGA-alignment en -positionering
- Inspecteert buitenste ballrij op bridges
- Kan verborgen verbindingen niet beoordelen
Elektrische Test (ICT / Flying Probe)
FUNCTIONEELVerifieert of alle BGA-verbindingen elektrisch correct functioneren. In-Circuit Test (ICT) bij hogere volumes, flying probe bij prototypes en kleine series.
- Detecteert opens, shorts, verkeerde componenten
- Boundary scan (JTAG) voor BGA-pinverificatie
- Detecteert geen voids of partiële verbindingen
Ons inspectieprotocol voor BGA
Wij hanteren een viervoudige inspectie: 3D SPI na stencildruk (100% van de pads), AOI na reflow, X-ray van alle BGA's en elektrische test. Bij IPC Klasse 3 voegen we CT-scan (3D X-ray) toe voor volumetrische voidanalyse. Dit protocol heeft onze BGA first-pass yield naar boven de 99% gebracht.
"Mijn vuistregel is eenvoudig: controleer elk ontwerp tegen IPC-A-610, IPC-2221 of IPC/WHMA-A-620 en houd minimaal 10% mechanische en thermische marge aan voordat u vrijgave geeft."
Hommer Zhao, Founder & CEO, WIRINGO

BGA Rework & Reparatie
Als X-ray inspectie of elektrische test een defect aan het licht brengt, is rework noodzakelijk. BGA rework is een gespecialiseerd proces dat vakmanschap en de juiste apparatuur vereist.
BGA Rework Proces in 5 Stappen
Lokale opwarming
IR of hetelucht-nozzle warmt alleen het BGA-component op, niet de omgeving. Thermisch profiel vergelijkbaar met reflow.
Component verwijdering
Vacuüm-nozzle tilt het component op zodra het soldeer is gesmolten. Minimale kracht om PCB-pads niet te beschadigen.
Padriniging
Restant soldeer wordt verwijderd met soldeerlont en flux. Pads worden geïnspecteerd op beschadiging of delaminatie.
Reballing of nieuw component
Bij hergebruik: component wordt gereballd met verse soldeerballen. Alternatief: nieuw component met verse ballen uit de verpakking.
Herplaatsing & reflow
Component wordt met vision alignment herplaatst. Lokale reflow met gecontroleerd profiel. X-ray verificatie achteraf verplicht.
Beperkingen van BGA rework
Volgens IPC-7711/21 zijn maximaal 2-3 rework cycli per pad toegestaan. Elke cyclus degradeert het koper en de soldermask. Bij IPC Klasse 3 toepassingen is rework nog restrictiever en kan een nieuwe board vereist zijn. Bereken altijd of rework economisch zinvol is ten opzichte van een nieuwe run.
PCB Design Tips voor Betrouwbare BGA Assemblage
Een goed BGA-assemblageresultaat begint bij het PCB-ontwerp. Deze design-richtlijnen helpen u de yield te maximaliseren en rework te minimaliseren.
1Kies NSMD Pads (Non-Solder Mask Defined)
Bij NSMD pads definieert het koper de padgrootte, niet de soldermask-opening. Dit geeft een grotere soldeervlakoppervlak en sterkere verbinding. Standaard voor BGA-pitch ≤0.8mm. Gebruik SMD (Solder Mask Defined) alleen bij >1.0mm pitch of als de leverancier dit adviseert.
2Via-in-Pad: Plug met Epoxy en Plaat Over
Via's direct in BGA-pads zijn vaak nodig voor escape routing, maar open via's veroorzaken solder wicking en voids. Gebruik via-in-pad met epoxyvulling en koper-overplating. Budget hiervoor €3-6 per board extra. Alternatief: dog-bone routing met via naast de pad.
3Gebruik ENIG als Oppervlakteafwerking
ENIG (Electroless Nickel Immersion Gold) biedt de platte, oxidatiebestendige padoppervlak die BGA vereist. HASL is niet geschikt voor fine-pitch BGA vanwege de onregelmatige tinlaag. OSP is een budget-alternatief maar minder bestand tegen meerdere reflow-cycli.
4Voeg Fiducials Toe naast Elke BGA
Lokale fiducials (minimaal 2, bij voorkeur 3) naast elke BGA-positie zijn essentieel voor de vision-alignment van de pick-and-place machine. Plaats ze asymmetrisch en op minimaal 5mm afstand van de BGA-pads.
5Houd Rekening met Thermal Relief en Routing
Grote ground/power pads in het BGA-raster hebben meer warmte nodig om te solderen. Gebruik thermal reliefs op ground plane connecties. Verdeel escape routing over meerdere lagen conform de breakout-strategie van het BGA-package (fan-out via's).
De DFM-check is gratis — gebruik hem
Stuur uw Gerber-files altijd voor een DFM-check vóór productie. Wij controleren specifiek op BGA pad design, stencil-maakbaarheid, via-in-pad configuratie en routing. In 30% van de gevallen vinden wij optimalisatiemogelijkheden die rework voorkomen. Die check kost niets — de rework wel.
"Mijn vuistregel is eenvoudig: controleer elk ontwerp tegen IPC-A-610, IPC-2221 of IPC/WHMA-A-620 en houd minimaal 10% mechanische en thermische marge aan voordat u vrijgave geeft."
Hommer Zhao, Founder & CEO, WIRINGO
Kosten van BGA Assemblage
BGA assemblage is duurder dan standaard SMT vanwege strengere proceseisen en verplichte X-ray inspectie. Hieronder een realistische kostenopbouw voor 2026.
| Kostenpost | Prototype (10 st.) | Klein serie (100 st.) | Volume (500+ st.) |
|---|---|---|---|
| BGA placement (per stuk) | €0,50-1,00 | €0,15-0,30 | €0,03-0,08 |
| X-ray inspectie (per board) | €5-10 | €2-5 | €1-3 |
| Stencil (BGA-optimized) | €80-150 (eenmalig) | €80-150 (eenmalig) | €80-150 (eenmalig) |
| Via-in-pad (per board) | €3-6 | €2-4 | €1-3 |
| ENIG finish (meerprijs) | €0,80-2,00 | €0,80-2,00 | €0,50-1,50 |
| Totaal per board (indicatief) | €25-50 | €12-25 | €8-20 |
5 Tips om BGA Kosten te Verlagen
Kies de juiste pitch
Niet elk ontwerp heeft 0.4mm pitch nodig. Bij ≥0.8mm pitch dalen de eisen voor stencil, plaatsing en inspectie aanzienlijk.
Combineer met turnkey
In een turnkey assemblage worden NRE-kosten (stencil, programma) over meerdere orders gespreid.
Optimaliseer het stencilontwerp
Een goed stencilontwerp verhoogt de first-pass yield. Minder rework = lagere totaalkosten. Vraag uw assemblagepartner om stenciladvies.
Paneliseer slim
Meerdere boards per panel reduceert de X-ray kosten per board en verbetert de throughput van de assemblagelijn.
Verborgen kosten van slechte BGA-kwaliteit
Een defect dat €1 kost in de fabriek, kost €10 na assemblage en €100 in het veld. Bij een defectpercentage van 0,01% en 10.000 boards betekent dat al snel €5.000+ aan veldkosten. Bekijk onze complete PCB assemblage kostengids voor een volledige levenscyclusanalyse.
"Mijn grens is simpel: zodra toleranties minder dan 0,10 mm speling laten, moet het ontwerp aantoonbaar passen binnen IPC-A-610, IPC-6012 en het werkelijke procesvenster van de fabriek. Anders koopt u geen marge, maar herwerk."
Hommer Zhao, Founder & CEO, WIRINGO
Veelgestelde Vragen over BGA Assemblage
Wat is BGA assemblage en waarom wordt het gebruikt?
BGA (Ball Grid Array) assemblage is het solderen van IC-packages die via een raster van soldeerballen aan de onderzijde op de PCB worden verbonden. Het wordt gebruikt voor complexe IC's met honderden tot duizenden aansluitingen, omdat het een hogere pindichtheid biedt dan QFP of SOIC packages, kortere signaalwegen heeft en betere thermische geleiding. Denk aan processors, FPGA's, DDR-geheugen en SoC's.
Hoe worden BGA soldeerverbindingen geïnspecteerd?
Omdat de soldeerverbindingen verborgen zijn onder het component, is X-ray inspectie de standaardmethode. Hiermee worden voids, bridges, open verbindingen en misalignment gedetecteerd. Aanvullend worden AOI (buitenste rij ballen), ICT (In-Circuit Test) en functionele testen ingezet. Bij kritische toepassingen wordt 3D CT-scanning (3D röntgen) gebruikt voor volumetrische voidanalyse.
Wat kost BGA assemblage per board?
Voor prototypes (10 stuks) ligt de totale boardprijs op €25-50 inclusief BGA-assemblage. Bij volumes boven 500 stuks daalt dit naar €8-20 per board. De BGA-specifieke meerkosten ten opzichte van standaard SMT zitten in het stencilontwerp (€80-150 eenmalig), hogere plaatsingsnauwkeurigheid en verplichte X-ray inspectie (€1-10 per board).
Kan een BGA component worden gereworked?
Ja, met gespecialiseerde BGA rework stations. Het proces omvat lokale opwarming, verwijdering, padriniging, reballing en herplaatsing met vision alignment. Maximaal 2-3 rework cycli zijn toegestaan volgens IPC-7711/21. Na elke rework is X-ray verificatie verplicht. Voor IPC Klasse 3 toepassingen gelden nog strengere beperkingen.
Welke minimale BGA pitch kan mijn assemblagepartner aan?
De meeste ervaren assembleurs verwerken betrouwbaar tot 0.4mm pitch. Voor ultra-fine pitch (0.3mm en kleiner) is gespecialiseerde apparatuur nodig: pick-and-place met ±25µm nauwkeurigheid, laser-gesneden stencils en nitrogen reflow. Vraag altijd naar bewezen ervaring met uw specifieke BGA-pitch en referenties van vergelijkbare projecten.
Bronnen & Referenties
- IPC-7095 — Design and Assembly Process Implementation for BGAs. Beschikbaar via IPC Store
- IPC-7711/21 — Rework, Modification and Repair of Electronic Assemblies. Meer informatie via IPC public reference
- Electronics Notes — "How to Solder Ball Grid Arrays". Lees artikel
- IPC-9261 — In-Process DPMO and Estimated Yield for PWAs. Referentie voor yield-berekeningen. IPC public reference
Gerelateerde Artikelen
SMT vs THT Assemblage: Technische Vergelijking
Surface Mount vs Through-Hole technologie uitgelegd.
Lees meer KwaliteitPCB Testen & Kwaliteitscontrole: Complete Gids
SPI, AOI, X-Ray, ICT en functionele testen uitgelegd.
Lees meer PCB MaterialenHASL vs ENIG vs OSP Vergelijking 2026
Welke oppervlakteafwerking past bij uw BGA-project?
Lees meer"In meer dan 20 jaar productie-ervaring hebben wij geleerd dat kwaliteitscontrole op componentniveau 80% van de veldbetrouwbaarheid bepaalt. Elke specificatiebeslissing die u vandaag neemt, beïnvloedt de garantiekosten over drie jaar."
Hommer Zhao, Founder & CEO, WIRINGO